เหตุผลและวิธีการใช้ทรานซิสเตอร์ GaN Field Effect สำหรับการใช้งานโหมดพาวเวอร์ ที่แรงดันไฟฟ้าสูงกว่าอย่างมีประสิทธิภาพ
Contributed By DigiKey's North American Editors
2023-01-26
ประสิทธิภาพการใช้พลังงานเป็นสิ่งสำคัญอันดับแรกสำหรับระบบอิเล็กทรอนิกส์ เมื่อต้องเผชิญทั้งข้อกำหนดทางสังคมและข้อบังคับต่าง ๆ โดยเฉพาะอย่างยิ่ง สำหรับการใช้งานตั้งแต่รถยนต์ไฟฟ้า (EV) ไปจนถึงการสื่อสารไฟฟ้าแรงสูงและโครงสร้างพื้นฐานทางอุตสาหกรรม ประสิทธิภาพการแปลงพลังงานและความหนาแน่นของพลังงานเป็นสิ่งสำคัญสำหรับความสำเร็จในการออกแบบ
เพื่อตอบสนองความต้องการเหล่านี้ ผู้ออกแบบระบบพลังงานโหมดสวิตช์จำเป็นต้องเปลี่ยนจากการใช้ฟิลด์เอฟเฟกต์ทรานซิสเตอร์ (MOSFETs) ของโลหะออกไซด์แบบคลาสสิก (Si) และทรานซิสเตอร์เกตไบโพลาร์แบบหุ้มฉนวน (IGBT) เนื่องจากกำลังเข้าใกล้ขีดจำกัดทางทฤษฎีอย่างรวดเร็ว
นักออกแบบจำเป็นต้องพิจารณาอุปกรณ์ที่ใช้วัสดุไวด์แบนด์แกป (WBG) เช่น แกลเลียมไนไตรด์ (GaN) อุปกรณ์ GaN สลับได้เร็วกว่าอุปกรณ์ Si จัดการแรงดันไฟฟ้าและระดับพลังงานที่สูงกว่า มีขนาดเล็กกว่ามากสำหรับระดับพลังงานที่กำหนด และทำงานด้วยประสิทธิภาพที่สูงกว่ามาก
บทความนี้จะตรวจสอบพื้นฐานของ GaN FET โดยจะแสดงข้อได้เปรียบเหนืออุปกรณ์ Si แบบดั้งเดิมในวงจรไฟฟ้าโหมดสวิตช์ แนะนำตัวอย่างการใช้งานจริงจาก Nexperia และพูดคุยเกี่ยวกับการประยุกต์ใช้งานของอุปกรณ์ประเภทนี้
พื้นฐานของ GaN FET
องค์ประกอบพื้นฐานในวงจรแปลงกำลังคือสวิตช์เซมิคอนดักเตอร์แรงดันสูง นักออกแบบได้มุ่งเน้นไปที่การปรับปรุงประสิทธิภาพของอุปกรณ์เหล่านี้โดย: ลดการสูญเสียการนำไฟฟ้าโดยลดความต้านทานอนุกรมสถานะ ลดการสูญเสียการสลับโดยเพิ่มความเร็วในการเปลี่ยนผ่าน และลดผลกระทบแฝงต่าง ๆ โดยทั่วไป ความพยายามในการออกแบบเหล่านี้ประสบความสำเร็จสำหรับซิลิคอน MOSFET และ IGBT แต่อัตราการปรับปรุงช้าลงเนื่องจากการทำงานของอุปกรณ์เหล่านี้ถึงขีดจำกัดทางทฤษฎี
ด้วยเหตุนี้ ในช่วงหลายปีที่ผ่านมาจึงเห็นการเปิดตัวอุปกรณ์ WBG ที่ใช้ซิลิกอนคาร์ไบด์ (SiC) และ GaN จนถึงจุดที่สามารถผลิตได้ในปริมาณมาก อุปกรณ์เหล่านี้มีช่วงแรงดันไฟฟ้าในการทำงานที่สูงกว่า เวลาเปลี่ยนที่เร็วกว่า และมีประสิทธิภาพสูงกว่า
bandgap ของเซมิคอนดักเตอร์คือพลังงานขั้นต่ำที่จำเป็นสำหรับการกระตุ้นอิเล็กตรอนเพื่อปลดปล่อยอิเล็กตรอนจากสถานะที่ถูกผูกไว้ไปสู่สถานะอิสระเพื่อนำไฟฟ้า (ตารางที่ 1)
|
ตารางที่ 1: ข้อมูลสรุปของคุณสมบัติหลักที่ทำให้เซมิคอนดักเตอร์แบนด์แกปกว้าง เช่น GaN และ SiC แตกต่างจาก Si (แหล่งที่มาของตาราง: Art Pini)
อุปกรณ์ที่ผลิตด้วยเซมิคอนดักเตอร์แบนด์แกปกว้างสามารถทำงานที่แรงดันไฟฟ้า ความถี่ และอุณหภูมิที่สูงกว่าวัสดุเซมิคอนดักเตอร์ทั่วไป เช่น Si แบนด์วิดท์ที่กว้างขึ้นมีความสำคัญอย่างยิ่งต่อการช่วยให้อุปกรณ์ทำงานที่อุณหภูมิสูงขึ้นมาก ความทนทานต่ออุณหภูมิสูงหมายความว่าภายใต้สภาวะปกติ อุปกรณ์เหล่านี้สามารถทำงานได้ในระดับพลังงานที่สูงกว่ามาก สารกึ่งตัวนำ WBG ที่มีสนามไฟฟ้าวิกฤตสูงกว่าและมีความคล่องตัวสูงกว่าจะมีความต้านทานต่อสถานะเดรนจากแหล่งจ่าย (RDS(ON)) ซึ่งช่วยลดการสูญเสียการนำไฟฟ้า
วัสดุแถบกว้างส่วนใหญ่ยังมีความเร็วของอิเล็กตรอนอิสระสูง ซึ่งช่วยให้สามารถทำงานที่ความเร็วการสลับที่สูงขึ้นได้
เมื่อเทียบกับ Si ซึ่งมีแบนด์แกป 1.12 อิเล็กตรอนโวลต์ (eV) GaN และ SiC เป็นสารกึ่งตัวนำผสมที่มีแบนด์แกปสูงกว่า 3.4 eV และ 3.3 eV ประมาณสามเท่าตามลำดับ ซึ่งหมายความว่าทั้งคู่สามารถรองรับแรงดันไฟฟ้าและความถี่ที่สูงขึ้นได้
ความคล่องตัวของอิเล็กตรอนที่สูงขึ้นของ GaN ทำให้เหมาะสำหรับการใช้งานที่มีประสิทธิภาพสูงและความถี่สูง ความเร็วในการสลับที่เร็วขึ้นและความถี่การทำงานที่สูงขึ้นที่เปิดใช้งานโดย GaN power FETs ส่งผลให้การควบคุมสัญญาณดีขึ้น การออกแบบตัวกรองแบบพาสซีฟที่มีความถี่คัตออฟสูงขึ้น และกระแสกระเพื่อมต่ำลง ทำให้สามารถใช้ตัวเหนี่ยวนำ ตัวเก็บประจุ และหม้อแปลงที่มีขนาดเล็กลง ส่งผลให้ขนาดและน้ำหนักโดยรวมลดลง
GaN FETs เรียกว่าทรานซิสเตอร์การเคลื่อนที่ของอิเล็กตรอนสูง (HEMT) การเคลื่อนที่ของอิเล็กตรอนสูงเป็นหน้าที่ของโครงสร้าง FET (รูปที่ 1)
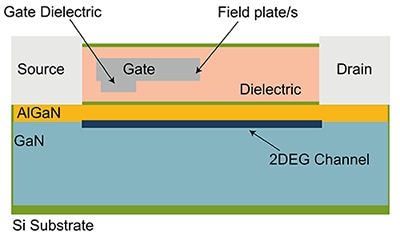 รูปที่ 1: มุมมองภาคตัดขวางของ GaN FET โดยอิงจากวัสดุพิมพ์ Si (แหล่งรูปภาพ: Nexperia)
รูปที่ 1: มุมมองภาคตัดขวางของ GaN FET โดยอิงจากวัสดุพิมพ์ Si (แหล่งรูปภาพ: Nexperia)
GaN FET ใช้โรงงานผลิตซิลิกอน CMOS ที่มีอยู่ ทำให้คุ้มค่า ชั้น GaN ถูกสร้างขึ้นบนสารตั้งต้น Si โดยการฝากชั้นเมล็ดพืชและชั้น GaN และอะลูมิเนียมแกลเลียมไนไตรด์ (AlGaN) ที่คัดเกรดแล้วเป็นชั้นแยก (ไม่แสดงในแผนภาพ) ก่อนที่ชั้น GaN บริสุทธิ์จะเติบโต ชั้น AlGaN ที่สองวางทับบนชั้น GaN สิ่งนี้สร้างโพลาไรเซชันแบบเพียโซอิเล็กทริก โดยมีอิเล็กตรอนส่วนเกินถูกสร้างขึ้นทันทีใต้ AlGaN ซึ่งเป็นช่องนำไฟฟ้าสูง อิเล็กตรอนส่วนเกินนี้เรียกว่าก๊าซอิเล็กตรอนสองมิติ (2DEG) ชื่อนี้สะท้อนถึงการเคลื่อนที่ของอิเล็กตรอนที่สูงมากในชั้นนี้
พื้นที่พร่องเกิดขึ้นใต้ประตู การทำงานของเกตคล้ายกับ N-channel, พาวเวอร์ซิลิกอน MOSFET ในโหมดเพิ่มประสิทธิภาพ แรงดันไฟฟ้าบวกที่ใช้กับประตูของอุปกรณ์นี้จะเปิดขึ้น
โครงสร้างนี้ทำซ้ำหลายครั้งเพื่อสร้างอุปกรณ์ไฟฟ้า ผลลัพธ์ที่ได้คือโซลูชันพื้นฐานที่เรียบง่าย หรูหรา และคุ้มค่าสำหรับการสวิตช์พลังงาน
เพื่อให้ได้อุปกรณ์ไฟฟ้าแรงสูง ระยะห่างระหว่าง เดรน และ เกต จะเพิ่มขึ้น เนื่องจากความต้านทานของ GaN 2DEG ต่ำมาก ผลกระทบต่อความต้านทานโดยการเพิ่มความสามารถในการปิดกั้นแรงดันไฟฟ้าจึงต่ำกว่ามากเมื่อเทียบกับอุปกรณ์ซิลิกอน
สามารถสร้าง GaN FET เพื่อใช้งานในสองรูปแบบ โหมดเพิ่มประสิทธิภาพหรือดีพลีทชั่นโหมด โดยปกติ FET โหมดเพิ่มประสิทธิภาพจะปิดอยู่ ดังนั้นจึงต้องใช้แรงดันไฟฟ้าบวกที่เกี่ยวข้องกับท่อระบายน้ำ/แหล่งที่มากับประตูเพื่อเปิด FET โดยปกติแล้ว FET โหมดพร่องจะเปิดอยู่ ดังนั้นจึงต้องใช้แรงดันเกตเชิงลบที่สัมพันธ์กับท่อระบายน้ำ/แหล่งที่มาเพื่อปิด FET FET ดีพลีทชั่นโหมดเป็นปัญหาในระบบไฟฟ้าเนื่องจากต้องใช้ไบแอสเชิงลบกับ FET ดีพลีทชั่นโหมดพร่อง GaN ก่อนเปิดระบบ
วิธีหนึ่งในการแก้ไขปัญหานี้คือการรวม FET ซิลิคอนแรงดันต่ำเข้ากับ GaN FET โหมดพร่องในการกำหนดค่าวงจร cascode (รูปที่ 2)
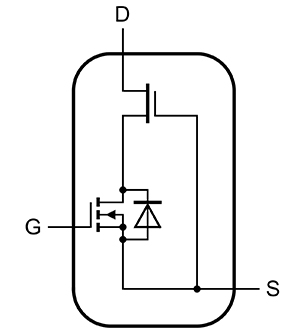 รูปที่ 2: MOSFET ซิลิกอนแรงดันต่ำที่อยู่ในการกำหนดค่า cascode ด้วย GaN FET ดีพลีทชั่นโหมดซึ่งส่งผลให้โครงสร้าง Si gate มีความแข็งแรงทนทาน พร้อมด้วยคุณสมบัติสัญญาณนาฬิกาแรงดันสูงที่ดีขึ้นของอุปกรณ์ GaN ขณะเดียวกัน ในกรณีของ GaN FET ดีพลีทชั่นโหมดอุปกรณ์แฝงปิดเมื่อเปิดเครื่อง (ที่มาของภาพ Nexperia)
รูปที่ 2: MOSFET ซิลิกอนแรงดันต่ำที่อยู่ในการกำหนดค่า cascode ด้วย GaN FET ดีพลีทชั่นโหมดซึ่งส่งผลให้โครงสร้าง Si gate มีความแข็งแรงทนทาน พร้อมด้วยคุณสมบัติสัญญาณนาฬิกาแรงดันสูงที่ดีขึ้นของอุปกรณ์ GaN ขณะเดียวกัน ในกรณีของ GaN FET ดีพลีทชั่นโหมดอุปกรณ์แฝงปิดเมื่อเปิดเครื่อง (ที่มาของภาพ Nexperia)
วงจร cascode ใช้โครงสร้างเกต Si MOSFET ซึ่งมีข้อได้เปรียบของขีดจำกัดเกตไดร์ฟที่สูงกว่าซึ่งตรงกับไอซีไดรเวอร์เกต MOSFET ที่มีอยู่ และ GaN FET ในดีพลีทชั่นโหมดจะปิดเมื่อเปิดเครื่อง
หนึ่งในคุณสมบัติที่สำคัญของ GaN FETs คือประสิทธิภาพสูง นี่เป็นเพราะ: ความต้านทานต่ออนุกรมต่ำ ซึ่งช่วยลดการสูญเสียการนำไฟฟ้า เวลาการสลับที่เร็วขึ้นซึ่งช่วยลดการสูญเสียการสลับ และค่าธรรมเนียมการกู้คืนแบบย้อนกลับที่ต่ำกว่า ซึ่งคิดเป็นการสูญเสียการกู้คืนแบบย้อนกลับที่ต่ำ
การใช้โทโพโลยีตัวแปลงบูสต์บริดจ์ทั่วไปทำให้สามารถเปรียบเทียบประสิทธิภาพของ GaN FET และ Si MOSFET ได้ (รูปที่ 3)
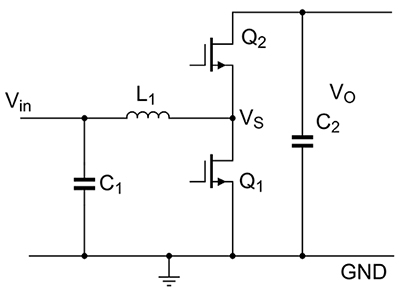 รูปที่ 3: แสดงเป็นแผนผังของ บูสต์คอนเวอร์เตอร์แบบฮาล์ฟบริดจ์ที่ใช้สำหรับเปรียบเทียบประสิทธิภาพของ MOSFET และ GaN FET โดยการแลกเปลี่ยนทรานซิสเตอร์ Q1 และ Q2 กับแต่ละประเภท (แหล่งรูปภาพ: Nexperia)
รูปที่ 3: แสดงเป็นแผนผังของ บูสต์คอนเวอร์เตอร์แบบฮาล์ฟบริดจ์ที่ใช้สำหรับเปรียบเทียบประสิทธิภาพของ MOSFET และ GaN FET โดยการแลกเปลี่ยนทรานซิสเตอร์ Q1 และ Q2 กับแต่ละประเภท (แหล่งรูปภาพ: Nexperia)
บูสต์คอนเวอร์เตอร์มีแรงดันอินพุต 240 โวลต์ เอาต์พุตคือ 400 โวลต์ และความถี่สวิตชิ่งคือ 100 กิโลเฮิรตซ์ (kHz) ประสิทธิภาพและการสูญเสียจะถูกเปรียบเทียบในช่วงกำลังสูงถึง 3500 วัตต์ (รูปที่ 4)
 รูปที่ 4: การเปรียบเทียบประสิทธิภาพและการสูญเสียพลังงานระหว่าง GaN FET และ MOSFET ในวงจรที่เหมือนกัน แสดงข้อดีของ GaN FET (ที่มาของภาพ Nexperia)
รูปที่ 4: การเปรียบเทียบประสิทธิภาพและการสูญเสียพลังงานระหว่าง GaN FET และ MOSFET ในวงจรที่เหมือนกัน แสดงข้อดีของ GaN FET (ที่มาของภาพ Nexperia)
GaN FET ทำงานได้อย่างมีประสิทธิภาพสูงขึ้นประมาณ 20% เมื่อเทียบกับ MOSFET และการสูญเสียพลังงานจะลดลงประมาณสามเท่า ที่ 2,000 วัตต์ การสูญเสียใน MOSFET จะอยู่ที่ประมาณ 62 วัตต์; ใน GaN FETs มีเพียง 19 วัตต์เท่านั้น ซึ่งหมายความว่าระบบระบายความร้อนอาจมีขนาดเล็กลง ซึ่งจะช่วยปรับปรุงประสิทธิภาพเชิงปริมาตรของบูสต์คอนเวอร์เตอร์
สิ่งที่เห็นได้ชัดน้อยกว่าคือการวัดได้ดำเนินการไปเกือบ 3500 วัตต์สำหรับ GaN FET เนื่องจากขีดจำกัดแรงดันไฟฟ้าสูงสุดที่สูงกว่า ด้วยเหตุนี้ GaN FET จึงมีข้อได้เปรียบที่ชัดเจน
เริ่มต้นใช้งาน GaN สำหรับแรงดันไฟฟ้าที่สูงขึ้น
สำหรับการใช้งานแรงดันไฟฟ้าที่สูงขึ้น Nexperia ขอเสนอ GaN FET 650 โวลต์ 2 ชุดคือ GAN063-650WSAQ และ GAN041-650WSBQ ทั้งคู่เป็น N-channel FET ที่ปกติจะปิดอยู่ GAN063-650WSAQ ได้รับการจัดอันดับให้รองรับแรงดันเดรนจากแหล่งจ่ายสูงสุดที่ 650 โวลต์ และสามารถคงสภาพชั่วคราว (ที่มีความกว้างพัลส์น้อยกว่า 1 ไมโครวินาที) ที่ 800 โวลต์ ระดับกระแสไฟเดรน 34.5 แอมแปร์ (A) และกำลังไฟ 143 วัตต์ที่อุณหภูมิ 25°C ความต้านทานในสถานะเดรนไปยังแหล่งกำเนิดโดยทั่วไปคือ 50 มิลลิโอห์ม (mΩ) โดยมีขีดจำกัดสูงสุดที่ 60 mΩ
GAN041-650WSBQ มีพิกัดแรงดันไฟฟ้าจากเดรนถึงซอร์สสูงสุด 650 โวลต์เท่ากัน โดยมีขีดจำกัดชั่วคราว 800 โวลต์เท่ากัน ต่างกันตรงที่สามารถรองรับกระแสไฟเดรนสูงสุด 47.2 A และกำลังไฟสูงสุด 187 วัตต์ที่อุณหภูมิห้อง ความต้านทานของช่องสัญญาณทั่วไปคือ 35 mΩ โดยสูงสุด 41 mΩ
การออกแบบอ้างอิงของ Nexperia โดยใช้ GAN063-650WSAQ ในการกำหนดค่าแบบฮาล์ฟบริดจ์แสดงในรูปที่ 5
 รูปที่ 5: การออกแบบที่แนะนำสำหรับสเตจพลังงานแบบฮาล์ฟบริดจ์โดยใช้ GAN063-650WSA GaN FET แผนผังแสดงเฉพาะไดรเวอร์ FET และสเตจเอาต์พุตฮาล์ฟบริดจ์ และส่วนประกอบที่เกี่ยวข้อง (แหล่งรูปภาพ: Nexperia)
รูปที่ 5: การออกแบบที่แนะนำสำหรับสเตจพลังงานแบบฮาล์ฟบริดจ์โดยใช้ GAN063-650WSA GaN FET แผนผังแสดงเฉพาะไดรเวอร์ FET และสเตจเอาต์พุตฮาล์ฟบริดจ์ และส่วนประกอบที่เกี่ยวข้อง (แหล่งรูปภาพ: Nexperia)
แผนผังแสดงไดรเวอร์เกตแยกสูง/ต่ำ Si8230 ซึ่งใช้ในการขับเคลื่อนเกตของ GaN FET เอาต์พุตของไดรเวอร์เกตเชื่อมต่อกับเกตผ่านตัวต้านทานเกต 30 Ω ซึ่งจำเป็นสำหรับอุปกรณ์ GaN ทั้งหมด ตัวต้านทานเกตจะควบคุมเวลาในการชาร์จของความจุเกต ซึ่งส่งผลต่อประสิทธิภาพการสลับแบบไดนามิก เครือข่าย RC ระหว่างท่อระบายน้ำและแหล่งที่มาของ FET ยังช่วยควบคุมประสิทธิภาพการสลับ ระดับเกตไดรฟ์สำหรับ GaN FET อยู่ระหว่าง 0 ถึง 10 ถึง 12 โวลต์
ความเร็วในการสลับสูงของ GaN FETs (โดยปกติจะอยู่ในช่วง 10 ถึง 11 นาโนวินาที (ns)) จำเป็นต้องมีการจัดวางอย่างระมัดระวังเพื่อลดการเหนี่ยวนำของปรสิต และการใช้ RC snubbers เพื่อลดเสียงเรียกเข้าเนื่องจากแรงดันและกระแสไฟฟ้าชั่วคราว มี RC snubbers หลายตัว (R17 ถึง 19 และ C33 ถึง 35) ในการออกแบบระหว่างแหล่งจ่ายไฟแรงสูงและกราวด์ Snubbers จะลดเสียงเรียกเข้าที่เกิดจากการทำงานร่วมกันของ GaN FET และเครือข่ายบายพาส ควรเชื่อมต่อ Snubbers ให้ใกล้กับท่อระบายของ FET ด้านสูงมากที่สุด พวกมันถูกนำไปใช้กับตัวต้านทานแบบยึดพื้นผิวและตัวเก็บประจุเซรามิกที่มีความต้านทานอนุกรมต่ำ (ESR) เพื่อลดการเหนี่ยวนำตะกั่ว
เครือข่ายคอมโพเนนต์ที่เกิดจาก R4, D1, C12, และ C13 เป็นแหล่งจ่ายไฟบูทสแตรปสำหรับไดรเวอร์เกตด้านสูง D1 ควรเป็นไดโอดที่มีความจุต่ำและเร็ว เนื่องจากความจุของจุดเชื่อมต่อมีส่วนทำให้เกิดการสูญเสียการสลับ R4 จำกัดกระแสการชาร์จที่พุ่งเข้ามา ใช้งานได้ดีที่ค่าในช่วง 10 ถึง 15 Ω
สรุป
ตั้งแต่ EV ไปจนถึงโครงสร้างพื้นฐานด้านการสื่อสารและอุตสาหกรรม ความต้องการประสิทธิภาพการแปลงพลังงานที่มากขึ้นและความหนาแน่นของพลังงานจำเป็นต้องเปลี่ยนจากโครงสร้าง Si แบบคลาสสิก ดังที่แสดงไว้ GaN FET เป็นแนวทางสำหรับการออกแบบยุคหน้าโดยให้แรงดันไฟฟ้าในการทำงานที่สูงขึ้น เวลาเปลี่ยนที่เร็วขึ้น และมีประสิทธิภาพที่สูงขึ้น ส่วนประกอบที่มีอยู่ทั่วไปซึ่งได้รับการสนับสนุนจากการออกแบบอ้างอิงในบางกรณี ช่วยให้นักออกแบบสามารถเริ่มโครงการและดำเนินการได้อย่างรวดเร็ว

Disclaimer: The opinions, beliefs, and viewpoints expressed by the various authors and/or forum participants on this website do not necessarily reflect the opinions, beliefs, and viewpoints of DigiKey or official policies of DigiKey.